
半导体封装

半导体封装是指将通过测试的晶圆按照产品型号及功能需求加工得到独立芯片的过程。
封装过程为:来自晶圆前道工艺的晶圆通过划片工艺后被切割为小的晶片(Die),然后将切割好的晶片用胶水贴装到相应的基板(引线框架)架的小岛上,再利用超细的金属(金锡铜铝)导线或者导电性树脂将晶片的接合焊盘(Bond Pad)连接到基板的相应引脚(Lead),并构成所要求的电路;然后再对独立的晶片用塑料外壳加以封装保护,塑封之后还要进行一系列操作,封装完成后进行成品测试,通常经过入检Incoming、测试Test和包装Packing等工序,最后入库出货。
半导体主要分为三大封装,是根据所用的材料来划分半导体器件封装形式,有金属封装、陶瓷封装、金属一陶瓷封装和塑料封装。

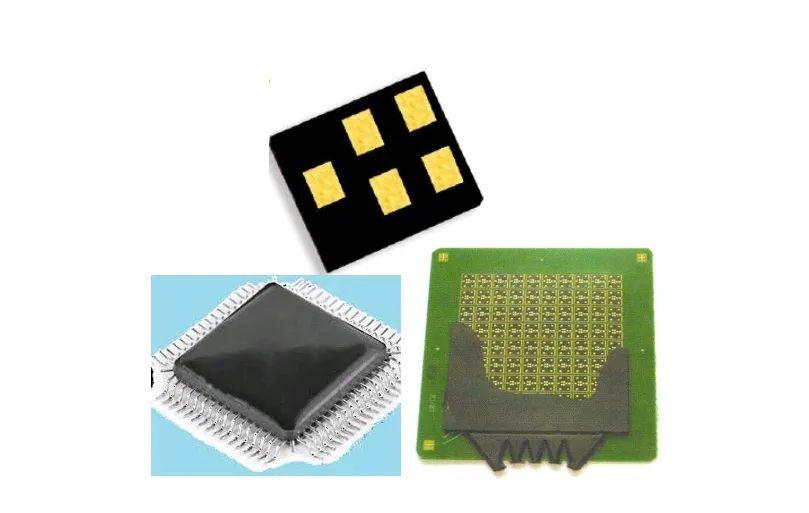
第一大类:半导体金属封装
金属封装始于三极管封装,后慢慢地应用于直插式扁平式封装,基本上乃是金属-玻璃组装工艺。由于该种封装尺寸严格、精度高、金属零件便于大量生产,故其价格低、性能优良、封装工艺容易灵活,被广泛应用于晶体管和混合集成电路如振荡器、放大器、鉴频器、交直流转换器、滤颇器、继电器等等产品上,现在及将来许多微型封装及多芯片模块(MCM)也采用此金属封装。金属封装的种类有光电器件封装包括带光窗型、带透镜型和带光纤型;分妒器件封装包括A型、B型和C型;混合电路封装包括双列直插型和扁平型;特殊器件封装包括矩正型、多层多窗型和无磁材料型。
第二大类:半导体陶瓷封装
早期的半导体封装多以陶瓷封装为主,伴随着半导体器件的高度集成化和高速化的发展,电子设备的小型化和价格的降低,陶瓷封装部分地被塑料封装代替,但陶瓷封装的许多用途仍具有不可替代的功能,特别是集成电路组件工作频率的提高,信号传送速度的加快和芯片功耗的增加,需要选择低电阻率的布线导体材料,低介电常数,高导电率的绝缘材料等。陶瓷封装的种类有DIP和SIP;对大规模集成电路封装包括PGA,PLCC,QFP和BGA。
第三大类:半导体塑料封装
塑料封装由于其成本低廉、工艺简单,并适于大批量生产,因而具有极强的生命力,自诞生起发展得越来越快,在封装中所占的份额越来越大。目前塑料封装在全世界范围内占集成电路市场的95%以上。在消费类电路和器件基本上是塑料封装的天下;在工业类电路中所占的比例也很大,其封装形式种类也是最多。塑料封装的种类有分立器件封装,包括A型和F型;集成电路封装包括SOP、DIP、QFP和BGA等
END

一文秒懂:封测的那些事儿!




 鄂公网安备42088102000192
鄂公网安备42088102000192