
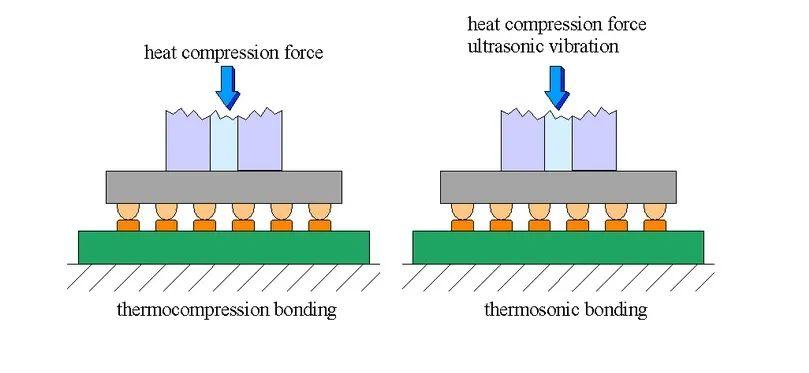
倒装芯片组装就是通过芯片上的凸点直接将元器件朝下互联到基板、载体或电路板上。而导线键合是将芯片的面朝上通过引线与基板、载体或电路板相连。
倒装芯片工艺由IBM公司于1962年发明,最早是应用在陶瓷基板上的固态逻辑技术。典型的倒装芯片工艺主要有:
1. 环氧树脂固化法
2. 各向异性导电胶固化法
3. 超声热压倒装芯片焊接法
4. 再流倒装芯片焊接法(C4技术)
其中热压超声倒装芯片技术工艺简单,扩大了连接材料的选择范围,降低了加工温度、减小压力、缩短时间。该方法使用热压超声倒装焊机完成凸点的焊接,热压超声倒装焊机由光学摄像对位系统、捡拾热压超声焊头、精确定位承片台及显示屏等组成。
倒装芯片技术与其它技术相比,在尺寸、外观、柔性、可靠性以及成本等方面有很大的优势。具有 I/O 密度高、互连线短、散热性好、生产率高以及互连过程中可自对准等优点,它的进步大大降低了电子封装工业的成本,显著提高了封装的可靠性和产量。

一文秒懂:封测的那些事儿!




 鄂公网安备42088102000192
鄂公网安备42088102000192